Основные операции фотолитографического процесса
Основные операции фотолитографического процесса
Фотолитография - процесс избирательного травления поверхностного слоя с использованием защитной фотомаски.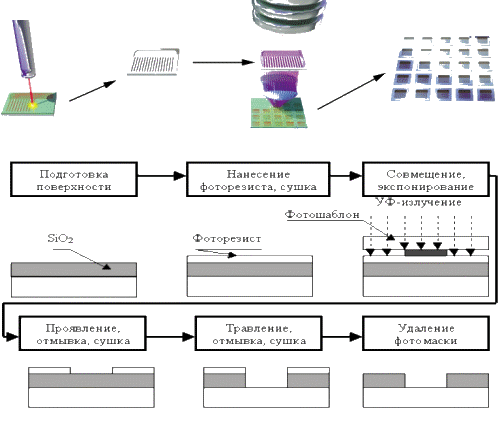
Подготовка поверхности. Подготовка поверхности к нанесению фотослоя заключается в её обработке парами органического растворителя для растворения жировых плёнок, которые препятствуют последующему сцеплению фоторезиста с поверхностью. Отмывка сверхчистой (деионизованой) водой удаляет следы растворителя; а также микрочастицы, способные впоследствии образовать "проколы" в тонком (»1 мкм) слое фоторезиста.
Нанесение фотослоя. При нанесении фотослоя используется раствор светочувствительного полимера в органическом растворителе (фоторезист). Для получения тонких слоёв фоторезиста на поверхности пластины его вязкость должна быть очень мала, что достигается высоким содержанием растворителя (80-95 % по массе). В свою очередь, с уменьшением толщины фотослоя повышается разрешающая способность фотолитографического процесса. Однако, при толщинах менее 0,5 мкм плотность дефектов ("проколов") в фотослое резко возрастает, и защитные свойства фотомаски снижаются. Нанесение фотослоя может быть выполнено одним из двух способов: центрифугированием или распылением аэрозоля. В случае использования центрифуги дозированное количество фоторезиста подаётся в центр пластины, прижатой вакуумом к вращающейся платформе (центрифуге). Жидкий фоторезист растекается от центра к периферии, а центробежные силы равномерно распределяют его по поверхности пластины, сбрасывая излишки в специальный кожух. Толщина h нанесённой плёнки зависит от скорости вращения платформы , от вязкости фоторезиста Скорость вращения центрифуги около 6000 об/мин, толщина фотослоя регулируются подбором соответствующей вязкости, т.е. содержанием растворителя.
Для центрифугирования характерны следующие недостатки:
- Трудность получения относительно толстых (в несколько микрометров) и равномерных плёнок из-за плохой растекаемости вязкого фоторезиста.
- Напряжённое состояние нанесённой плёнки, что приводит на этапе проявления к релаксации участков фотомаски и изменению их размеров.
- Наличие краевого утолщения как следствие повышения вязкости в процессе выравнивания, что ухудшает контакт фотошаблона с фотослоем.
- Трудность организации одновременной обработки нескольких пластин.
При распылении аэрозоли фоторезист подаётся из форсунки на пластины, лежащие на столе, совершающем возвратно-поступательное движение. Необходимая толщина формируется постепенно. Отдельные мельчайшие частицы растекаются и, сливаясь, образуют сплошной слой. При следующем проходе частицы приходят на частично просохший слой, несколько растворяя его. Поэтому время обработки, которое зависит от вязкости, расхода и "факела" фоторезиста, от скорости движения стола и расстояния от форсунки до подложки, устанавливается экспериментально. При реверсировании стола крайние пластины получат большую дозу фоторезиста, чем центральные. Во избежание утолщения слоя на крайних пластинах форсунке также сообщается возвратно-поступательное вертикальное движение (синхронно с движением стола). При торможении стола в конце хода форсунка поднимается вверх и плотность потока частиц в плоскости пластин снижается.
Распыление аэрозоли лишено недостатков центрифугирования, допускает групповую обработку пластин, но предъявляет более жёсткие требования к чистоте (отсутствие пыли) окружающей атмосферы. Нанесение фоторезиста и последующая сушка фотослоя являются весьма ответственными операциями, в значительной степени определяющими процент выхода годных микросхем. Пылевидные частицы из окружающего воздуха могут проникать в наносимый слой и создавать микродефекты. Нанесение фотослоя должно выполнятся в условиях высокой обеспыленности в рабочих объёмах (боксах, скафандрах) 1 класса с соблюдением следующей нормы: в 1 литре воздуха должно содержатся не более четырёх частиц размером не более 0,5 мкм. При сушке нанесённого слоя в слое могут сохраниться пузырьки растворителя, а при выходе на поверхность слоя они могут образовать микротрещины. Поэтому сушка выполняется с помощью источников инфракрасного излучения, для которого фоторезист является прозрачным, а, следовательно, поглощение излучения с выделением тепла происходит на границе " пластина - фоторезист ". Следовательно, сушка протекает от нижних слоёв фоторезиста к верхним, обеспечивая свободное испарение растворителя. Во избежание преждевременной полимеризации (задубления) фоторезиста и потери им чувствительности температура сушки должна быть умеренной (»100÷120°С). Перечисленные виды дефектов фотослоя (пылевидные частицы, микропузырьки и микротрещины) сохраняются в фотомаске и наследуются оксидной маской, создавая в ней микроотверстия. При использовании оксидной маски для избирательного легирования примесь будет проникать через них, образуя легированные микрообласти и, как следствие, токи утечки и пробои в p-n-переходах. Если оксидная маска представляет собой слой контактных окон, то металл, проникая в микроотверстия, может привести к паразитным связям между областями и коротким замыканиям.
Совмещение и экспонирование. Под совмещением перед экспонированием понимается точная ориентация фотошаблона относительно пластины, при которой элементы очередного топологического слоя (на фотошаблоне) занимают положение относительно элементов предыдущего слоя (в пластине), предписанное разработчиком топологии. Например, фотошаблон, несущий рисунок эмиттерных областей должен быть точно ориентирован относительно пластины, в которой уже сформированы базовые области.
Проявление.Проявление скрытого изображения для негативных фоторезистов заключается в обработке фотослоя органическим растворителем. При этом участки, не подвергшиеся облучению, растворяются, а облучённые участки, где при поглощении ультрафиолетового излучения происходит разрыв межатомных связей и перестройка структуры (фотополимеризация), сохраняются В позитивных фоторезистах на участках, подвергшихся облучению, происходит разрушение структуры (деструкция) с образованием кислоты. Для перевода её в растворимые слои применяют раствор неорганического соединения со щелочными свойствами (KOH, NaOH и др). После отмывки от следов проявителя и сушки полученную фотомаску подвергают тепловому задубливанию (120÷180°С в зависимости от марки фоторезиста), в результате чего окончательно формируются её защитные свойства.
Травление. При травлении в жидких травителях используются водные растворы неорганических соединений (обычно кислот). Химический состав и концентрация травителя в растворе подбирается так, чтобы поверхностный слой растворялся активно, а нижележащий не растворялся. С травлением в жидких травителях связано не только явление подтравливания под фотомаску, но и разброс величины подтравливания в совокупности элементов одного слоя. К моменту окончания растворения слоя в "окне" фотомаски боковое травление оказывается примерно равным толщине слоя , однако момент окончания травления зависит от размеров вытравливаемого элемента (окна в маске). В процессе травления имеют место отвод продуктов химической реакции от поверхности в раствор и подвод из раствора свежего травителя. Оба процесса протекают благодаря взаимодиффузии, скорость которой и определяет скорость травления. В мелких элементах массообмен затруднён и скорость травления ниже, чем в крупных элементах. Поскольку технологическое время травления устанавливают по самому мелкому элементу, более крупные элементы получают "перетрав", т.е. большие погрешности размера. Для повышения точности травления, т.е. уменьшения разброса размеров элементов из-за растрава, необходимо динамическое воздействие травителя на обрабатываемую по-верхность.. Форсунка для травителя обеспечивает ускоренную подачу свежего травителя к поверхности, вытесняя продукты реакции, а центробежные силы ускоряют отвод отработанного травителя. Существенное повышение точности травления достигается при использовании вакуум-плазменных ("сухих") методов травления, при которых разрушение слоя происходит механически за счёт бомбардировки потоком заряженных частиц (ионов инертного газа). С этой целью в вакуумной камере при давлении газа 1÷10 Па зажигается разряд и обрабатываемая пластина в качестве катода подвергается обработке ионами с энергией до 1 кэВ. Структура полимерной фотомаски и её толщина сохраняют её защитные свойства до окончания обработки слоя. Поскольку движение ионов инертного газа (обычно аргона) происходит по нормали к поверхности пластины, вытравленные участки точно соответствуют размерам окон фотомаски, т.е. эффект подтравливания отсутствует.
Ограничения контактной литографии: неизбежность механических повреждений рабочих поверхностей фотошаблона и пластин
вдавливание в фоторезистивный слой пылинок, микрочастиц, а также налипание фоторезиста на фотошаблоне при полномом контакте
невозможность обеспечить плотного контакта из-за неидеальности плоскости контактирующей поверхности, что приводит к снижению контактной стойкости
Бесконтактная литография: на контактном зазоре проекционная
Перспективные методы литографии Одним из принципиальных ограничений фотолитографии является разрешающая способность, так как длины волн ультрафиолетового света составляют 0,3 наномнтра. Каким бы малым не было отверстие в рисунке фотошаблона, размеры изображения этого отверстия в фоторезисте не могут достигнуть указанного значения из-за дифракции. После проявления и травления окисла разрешающая способность снижается до 250-500 линий на мм. Для повышения разрешающей способности литографии используется для экспозиции более коротковолновых излучений – рентгена.
Этот метод основан на взаимодействии рентгеновского излучения с рентгено-резистами, приводящее к изменению их свойств, а именно увеличению или уменьшению стойкости проявителю
Разработаны методы электронной литографией. Сущность: сфокусированным пучком электронов сканируют по поверхности пластины, покрытой резистом и управляют интенсивностью пучка в соответствии с заданной программой. В точках, которые должны быть "засвечены" ток пучка максимален, а которые должны быть "затемнены" – минимален или равен нулю. Диаметр пучка электронов находятся в прямой зависимости от тока в пучке, а именно, чем меньше диаметр, тем меньше ток.
Ионно-лучевая литография основана на использовании ионов гелия для экспонированной поверхности пластин покрытых резистом. Различают 2 метода ионно- лучевой литографии:
1) Сканирующая – с фокусирующим лучом аналогична ионной литографии.
2) Проекционная – основана на облучении колленированным лучем шаблона, находящимся на небольшом расстоянии от покрытой резистом пластины – аналогично рентгеновской литографии.
Эффективным при производстве БИС или СБИС является сочетание технологий фото, электронной и рентгеной литографии, а именно при изготовлении шаблонов применяют электронную литографию, а при экспонировании пластины ультрафиолетовые, электронные или рентгеновские лучи.
Получение субмикронных размеров достигается не только совершенствованием литографических процессов, а во многом зависит от способов травления маскирующего материала.
Наиболее эффективным методом является применение в проекционной литографии и сухих методов травления, а именно ионного и плазмо-химического.
